Automation Machinery
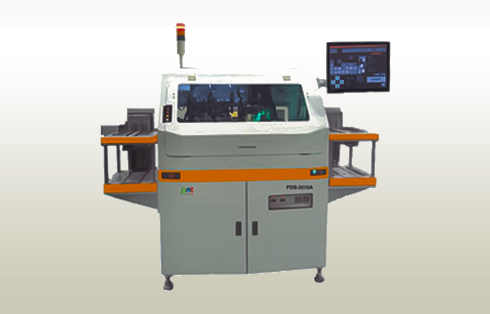
LED Die Bonder
LED 다이본더
The die bonder bonds semiconductor chips, completed through sewing on semiconductor wafers, to lead frames at high speed. It attaches chips onto lead frames or PCBs, establishing electrical connections between the chip and external circuits.
Chips that have undergone the die bonding process must withstand physical pressure during packaging and efficiently dissipate heat generated during operation. The bonding method is critical, especially as chips become smaller, to maintain consistent electrical conductivity or high insulation when required.
Specifications
| 구분 | 사양 |
|---|---|
| Description |
General Specification
|
| Cycle Time |
180ms
|
| X,Y Placement |
± 35㎛ under
|
| Wafer |
6” Standard (8” Option)
|
| Material |
Die Size : 0.15×0.15 ~ 5.08~5.08mm
|
| Vision |
256 Gray Level ( Resolution : 480×480 Pixel )
|
| Bonding Force |
30~ 300g (Programmable)
|
| Space |
1,600(L) × 1,300(W) × 1,700(H)
|

